SOI硅片擁有極高性能,被廣泛應用于高端芯片中,單晶硅錠經過切割、研磨和拋光處理后得到拋光片。
拋光片經過外延生長形成外延片,拋光片經過氧化、鍵合或離子注入等工藝處理后形成 SOI 硅片。
拋光片可直接用于制作半導體器件,廣泛應用于存儲芯片與功率器件等。
功率半導體是能夠支持高電壓、大電流的半導體。具有不同于一般半導體的結構,在使用高電壓、大電流時也不會損壞。
另外,由于使用大功率容易發熱產生高溫,成為故障發生的原因。 因此,正努力減少功率半導體本身因發熱而導致的功率損失,有效地將其產生的熱量釋放到外部。
為了提高集成電路的集成度和速度,降低功耗必須縮小器件的尺寸。但當器件的尺寸縮小到亞微米范圍以內時,常規的結構就不適應了,從而導致SOI( Silicon On Insulator或Semi- conductor On Insulator)結構的發展,也就是把器件制作在絕緣襯底上生長的硅單晶層上。SOI結構開始是針對亞微米CMOS器件提出來以取代不適合要求的常規結構以及已經應用的sos結構(sos可以看成是SOI的一種形式),但SOI結構很快也成為實現高速集成電路及三維集成電路的新途徑(但不是所有的SOI結構都可以用來做三維集成電路),是當前半導體材料研究的一個熱點問題。
| Diameter | 4" | 5" | 6" | 8" | |
| Device Layer | Dopant | Boron, Phos, Arsenic, Antimony, Undoped | |||
| Orientation | <100>, <111> | ||||
| Type | SIMOX, BESOI, Simbond, Smart-cut | ||||
| Resistivity | 0.001-20000 Ohm-cm | ||||
| Thickness (um) | 0.2-150 | ||||
| The Uniformity | <5% | ||||
| BOX Layer | Thickness (um) | 0.4-3 | |||
| Uniformity | <2.5% | ||||
| Substrate | Orientation | <100>, <111> | |||
| Type/Dopant | P Type/Boron , N Type/Phos, N Type/As, N Type/Sb | ||||
| Thickness (um) | 300-725 | ||||
| Resistivity | 0.001-20000 Ohm-cm | ||||
| Surface Finished | P/P, P/E | ||||
| Particle | <10@.0.3um | ||||
SOI結構的優點大致可以歸納為如下幾個方面:
(1)由于它是介質隔離,寄生電容小,對高速和高集成度的IC電路特別有利
(2)由于介質隔離,降低了噪聲,并提高了線路和器件的抗輻射性能。
(3)抑制了CMOS電路的“鎖住”( latch-u-up)問題。
SOI與SOS相比,SOI材料的完整性比sos好得多,比SOS應用的范圍也廣泛CMOS電路中采用SOI結構,可以減少掩蔽次數,也不需要隔離擴散,使線路布局簡化,提高集成度。SOS中Si與Al2O3的熱膨脹系數不匹配,硅層內有壓縮應力。此外,SO1的功耗和襯底成本都比SOS低得多,SOS沒有實現三維器件結構功能。
從目前情況來看,有的SOI技術已初步走向實用化,只要能進一步克服工藝和材料質量問題,實用化是沒有問題的,某些SOI技術可以用于三維IC的制造SOI結構材料制備的方法有很多種,下面簡要介紹幾種主要的方法:
1.熔化橫向生長
這種方法的基本工藝是在硅襯底上形成一層SO膜,然后在膜上淀積多晶或非晶硅所淀積的多晶或非晶硅局部熔化,移動熔區則在熔區前的多晶或非晶硅熔化,而熔區后面則進行再結晶。這種方法由于形成熔區的熱源不同可分成:①激光束熔化再結晶;②電子束熔化再結晶;③石墨帶狀加熱橫向有籽晶再結晶;光照熔融再結晶法等四種。由于其加熱方式不同,所以設備和具體工藝有很大的差別,結果也不一樣,各自有自己的優缺點。早期這類方法研究得比較活躍。
2.CVD橫向生長
CVD橫向生長法是在SiO2上進行側向鋪伸外延生長,簡稱ELO( Epitaxial Lateral Over growth)法。它是在選擇外延上發展起來的,很受人們重視。這是因為硅外延生長技術比較成熟,處理溫度低(1050~1150℃),遠低于Si熔化溫度,不會引起嚴重的襯底雜質的再分布,并且有希望用于三維IC的制作
本方法的基本過程是,在SiO2膜上用光刻技術開出襯底的窗口,在窗口處外延生長硅,抑制在SiO2表面上硅成核。當窗口區長滿硅后,再以足夠大的橫縱向生長速度比進行側向鋪伸外延。這個方法的關鍵在于如何抑制在SiO2上成核,目前利用生長/腐蝕工藝來解決這個問題,即每生長一段時間后停止生長,通入HCl氣相腐蝕,以除去在SiO2上淀積的硅。然后進行第二次生長/腐蝕,直到窗口長滿,繼續重復生長/腐蝕進行側向生長,最后硅膜連成一片并長到要求的厚度、所得的SOI結構的硅膜電學性質和器件性質和相同條件下常規外延生長的膜相近。現在還不能完全除去SiO2膜上的多晶核,使ELO膜的質量受到影響,另外橫向生長的寬度還不是很寬。
3.氧離子注入形成SOI結構
這種方法也叫做 SIMOX法(Separation by Implanted Oxygen)。它是利用注氧離子形成符合化學計量比的SiO2埋層的方法。注入的氧離子量約為1.2~1.8×10/cm2。埋層深度和注入能量有關,若埋層深度為0.5μm,則注入能量約為500keV,若深度為1um,則需要1MeV
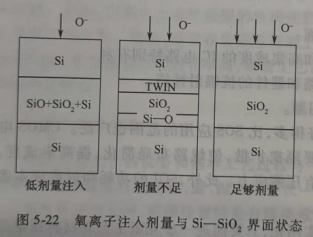
氧離子注入時,為了得到突變的Si—SiO2界面,通常把注入劑量適當過量,略大于1.8×1018/cm2。劑量不足時,在上界面處會出現孿晶層。圖5-22是注入劑量與SiSIO2界面狀態的示意圖。
氧離子注入后,必須進行高溫退火熱處理,使O與Si作用形成SiO2并消除晶格的損傷,處理溫度為1150~1250℃,時間為2h。退火前,在硅片表面淀積一層SiO2能有助于提高退火效果并能減少表面缺陷。
SIMOX法簡單易行,能得到良好的單晶層與常規硅器件工藝完全相容。它可以說是目前SOI技術中最引人注意的,但不足的是它無法做成三維的器件。
4.硅片面鍵合法
這種方法是將兩片硅片通過表面的SiO2層鍵合在一起,再把背面用腐蝕等方法減薄獲得SOI結構。實施的辦法之一是,將兩片硅的拋光片一片氧化形成SiO2膜,將另一片貼在其上,在氧氣氛中熱處理,在氧化熱處理過程中通過界面的硅氧鍵的聚合作用而黏結在一起。這種方法比較簡單,但減薄處理比較困難,另外對片子的平整度要求高,否則整個界面很難完全貼合。這種方法目前發展較快。
SOI技術已經研究很多年,取得一些結果,各先進工業國都投入不少力量進行研究,一旦獲得突破性的進展,其應用前景是十分廣闊的。
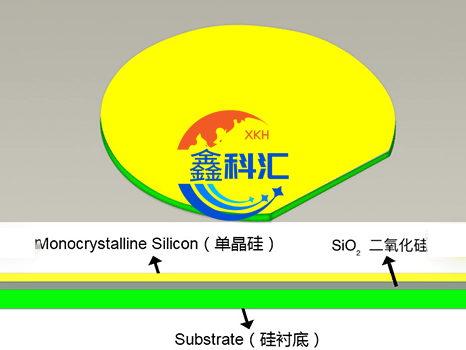
 售前咨詢專員
售前咨詢專員
